発表のポイント
- 次世代半導体の回路基板と目されているガラス基板に対し、直径10マイクロメートル以下の微細穴あけ加工を深紫外レーザーで実現しました。
- 深紫外領域の超短パルスレーザーを用いることで、ガラス基板に対し、配線用に利用可能な細く長い(高アスペクト比)穴あけ加工を高密度にできることを実証しました。
- 今後さらなる微細化と高アスペクト比化そして高速化を実現することで、半導体製造の後工程において材料と加工技術における日本のプレゼンス向上が期待されます。
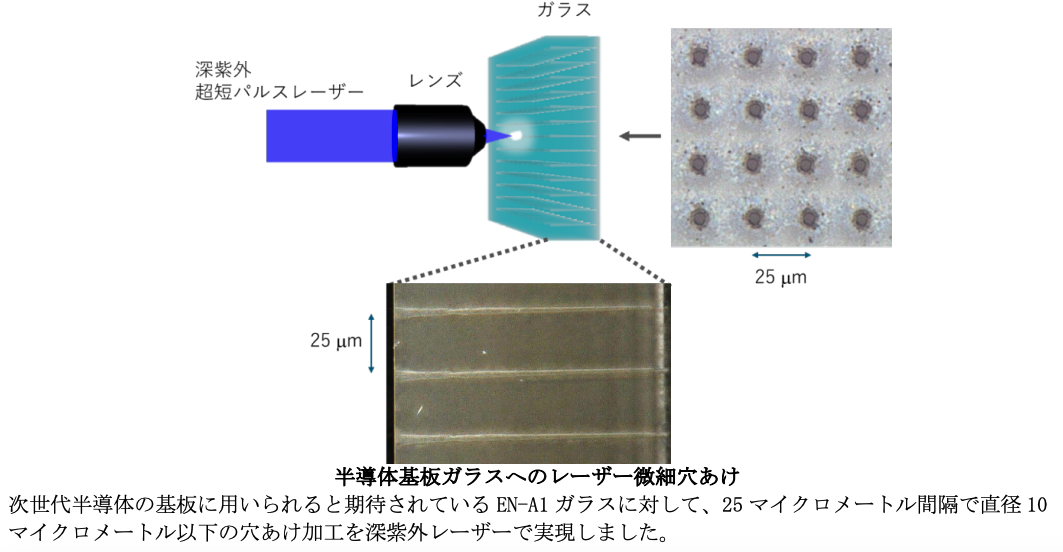
概要
国立大学法人東京大学(総長 藤井 輝夫)は、半導体基板用ガラスへの極微細レーザー穴あけ加工技術を開発しました。今回用いたガラス基板はAGC株式会社より提供された EN-A1(注 1)で、次世代の半導体製造「後工程」(注 2)に用いられる候補材料の一つです。本研究で開発された手法を用いると、レーザーのみで直径10 マイクロメートル以下、アスペクト比(注3)が20程度の微細な穴あけができ、従来のエッチングによる穴あけよりも高いアスペクト比の加工ができます。
この成果は今後生成AI等に必要なハイパフォーマンスコンピュータやデータセンター用のチップレット(注 4)において、回路基板の材料がガラスに移行する際に役に立つと期待されます。本研究グループは今後も産業界と連携して、半導体パッケージ基板のさらなる微細化や高品位化を目指し、次世代半導体産業における日本の競争力強化に貢献してまいります。
本成果の技術に関する詳細は、2025年5月27日からアメリカ・ダラスで開催される国際会議ECTC2025で報告されます。
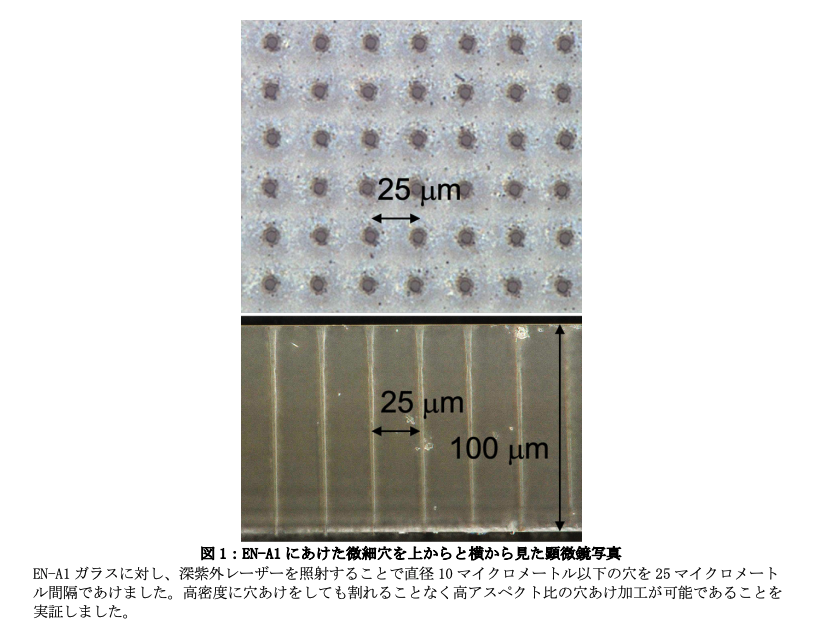
発表内容
〈発表の背景〉
露光技術の進歩に伴い、半導体チップは微細化するとともに大面積化も進んでいます。それとともに、半導体チップを実装する回路基板の配線も微細化と大面積化が求められています。さらにはbeyond 5Gや6Gの通信のために高周波化も重要となってきています。従来回路基板には樹脂が用いられていましたが、これらの要求に応えるために、基板の材料が樹脂からガラスへと移行するとされています。ガラスは高周波特性が良く、大面積で平坦、そしてシリコンと熱特性を合わせることができるといった特徴があります。回路基板には表と裏をつなぐ配線のために多数の貫通穴をあける必要がありますが、高密度の配線のためには微細な穴が必要となります。ところがガラスは脆性材料であるため、極端に小さな径で深い穴を真っ直ぐ精密にあけることは、ひび割れなどの問題があり大変困難です。ガラスの微細穴あけには大きく分けて、化学的なエッチングを使う手法とレーザーで穴あけをする手法がありますが、双方利点と欠点があり、いずれも確立した技術とはなっていません。そこで現在世界中でガラスへの微細かつ高アスペクト比の穴あけ加工技術の研究開発が行われています。
〈発表の内容〉
この度、本研究開発チームでは半導体基板として電気的・熱的特性が優れているEN-A1ガラスに対してレーザー加工のみで微細貫通穴加工を行いました。
超短パルスの深紫外レーザーを用いることで、ガラスに直径10マイクロメートル以下の穴を貫通させることができました。アスペクト比にするとおよそ20程度です。これまで、酸を使うエッチングでは高アスペクト比を実現することが困難でしたが、深紫外レーザーによる直接加工ではクラックがなく、高アスペクト比を実現できることが分かりました。本加工は化学処理を一切伴わないため廃液処理などの環境負荷も低減できます。
これは次世代半導体製造の後工程において基板のコア材やインターポーザ(注 5)をガラスへと移行する際に貫通穴をあける技術として、重要なマイルストーンとなるものです。この技術は今後半導体のさらなる微細化や複雑化するチップレット技術において貢献することが期待されます。
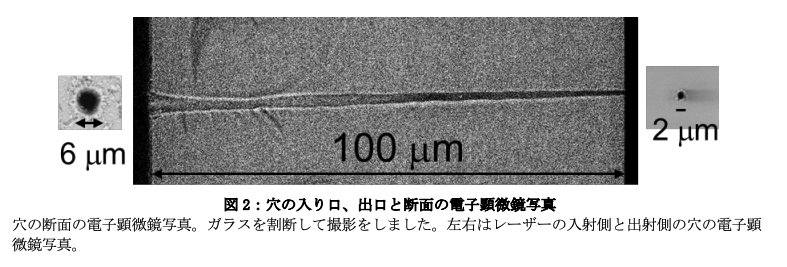
〇関連情報:
「DUV レーザーで半導体基板に世界最小の穴あけを実現――4 法人で半導体後工程技術を開発――」(2024/5/30)
https://www.issp.u-tokyo.ac.jp/maincontents/news2.html?pid=23292
発表者・研究者等情報
東京大学
物性研究所
小林 洋平 教授 <兼:同大学光量子科学連携研究機構>
乙津 聡夫 特任研究員
遠藤 翼 特任研究員
大学院理学系研究科附属 フォトンサイエンス研究機構
田丸 博晴 特任教授 <兼:同大学光量子科学連携研究機構>
AGC 株式会社
電子カンパニーASPプロジェクト 技術開発グループ
佐藤 陽一郎
技術本部 先端基盤研究所 機能化プロセス部
柴田 章広
学会情報
学会名:
ECTC(2025 IEEE 75th Electronic Components and Technology Conference)
題名:
High-aspect-ratio, 6-μm-diameter through-glass-via fabrication into 100-μmthick EN-A1 by dry laser micro-drilling process
著者名:
Toshio Otsu, Tsubasa Endo, Akihiro Shibata, Yoichiro Sato, Hiroharu Tamaru and Yohei Kobayashi
URL:
https://www.ectc.net/program/75-ECTCFinal-Web.pdf
研究助成
本研究の一部は、光・量子飛躍フラッグシッププログラム(Q-LEAP)により実施されました。
用語解説
(注 1)EN-A1:
AGC株式会社が提供する半導体回路基板用のアルカリフリーガラスの一つ。熱膨張係数がシリコンと近いためにシリコンチップを載せたときに反りが小さくなる。
(注 2)半導体後工程:
半導体製造工程のうちチップを作成するのが前工程、チップを実装するのが後工程。
(注 3)アスペクト比:
縦と横の比。穴あけの場合は深さと直径との比を表す。
(注 4)チップレット:
従来は一つのチップでロジック構成要素を一体で製造していたが、チップの大面積化に伴い歩留まりが悪くなってきた。チップレットとは、構成要素ごとに別チップとして製造した上で、パッケージ基板上に組み合わせて実装し一体のパッケージとして動作するよう製造する技術およびその手法。チップレット化により、後工程も含めて半導体の性能向上が期待されている。
(注 5)インターポーザ:
チップ間やチップと回路基板とをつなぐための中間的な基板。微細な配線と貫通穴からなる。チップレットなどの先端半導体パッケージに不可欠となってきている。
問合せ先
【研究に関すること】
東京大学 光量子科学連携研究機構 運営推進室 担当:三浦、白濱
TEL:03-5841-4130
E-mail:info@utripl.u-tokyo.ac.jp
【報道に関すること】
東京大学 物性研究所 広報室 担当:餅田 円
TEL:04-7136-3207(代表) 080-4940-9626(公用携帯)
E-mail:press@issp.u-tokyo.ac.jp
東京大学 大学院理学系研究科・理学部 広報室
TEL:03-5841-8856
E-mail:media.s@gs.mail.u-tokyo.ac.jp
出典:
https://www.issp.u-tokyo.ac.jp/news/wp-content/uploads/2025/05/press_0529_press_-DUV-ENA1.pdf
ご参考:
(株)光響が提供する製品・サービス情報:
・超短パルスレーザー(フェムト秒レーザー、ピコ秒レーザー)とは/技術紹介ページ
記事の追加及び削除:
記事の追加あるいは削除を希望される場合、お手数ではございますが、
以下窓口までご連絡ください。
info@symphotony.com
この情報へのアクセスはメンバーに限定されています。ログインしてください。メンバー登録は下記リンクをクリックしてください。